[转]BGA切片後如何判斷焊接品質
![[转]BGA切片後如何判斷焊接品質](https://www.mr-wu.cn/wp-content/uploads/2015/05/BGA-ball04.jpg)
BGA切片後如何判斷焊接品質
這篇文章基本上是寫給那些還不知道如何判斷切片後的BGA吃錫好壞的朋友參考用的。因為手邊剛好有幾張自己家產品切片後的BGA焊錫照片,剛好可以拿來做為教材之用,而且還有很典型的雙球(HIP, Head-In-Pillow)以及錫球被拉扯的照片。
通常拿到一張BGA的切片照片時,第一個要判斷的就是那一邊屬於BGA的封裝麵,那一邊又是屬於電路版組裝面。對於這個問題,我的方法是從銅箔的厚度來做判斷,銅箔比較厚的那一面通常是電路板組裝面,因為BGA封裝的載板通常都比電子組裝的電路板來得薄,所以會選用比較薄的銅箔厚度。
(當然這也只是個人對BGA的見解,如果有專家有意見也請留言指教)
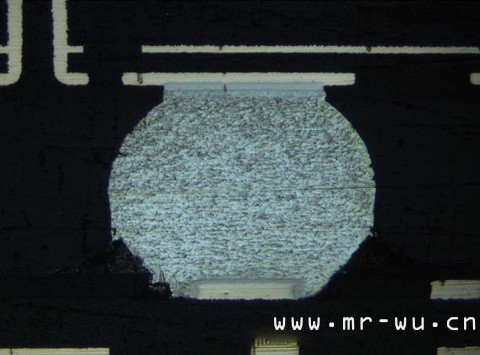
其次是如果已經可以明顯看到雙球現象時(如下圖為典型的HIP假冷焊缺點),球體比較大的那一面通常是載板上原來的錫球,因為BGA錫球的體積已經過一次Reflow,而印刷在PCB上的錫膏經過一次Reflow助焊劑揮發後剩下的體積就只有原來的一半了,所以BGA面的球體通常比較大。至於焊墊(焊盤)大小則不一定了,要看自家PCB佈線設計時有沒有堅持設計成【Cooper Define Pad Design(銅箔獨立焊墊設計)】。
接著判斷BGA焊接的好壞,下圖可以很清楚看出典型【雙球(HIP)】焊接問題,不瞭解的朋友可以點擊【HIP(Head-in-Pillow 枕頭效應)】連結做進一步探討,應該有99%的HIP都發生在BGA的四周最外面一排的錫球上,原因也幾乎都是BGA載板或PCB經Reflow時發生變形翹曲,等板子回溫後變形變小,但熔融的錫已經冷卻,於是形成雙球靠在一起的模樣。HIP就是嚴重的BGA焊錫不良,它很容易通過工廠內的測試程序流到客戶的手上,可是使用一段時間後產品就會因為出現問題而被送回來修理。
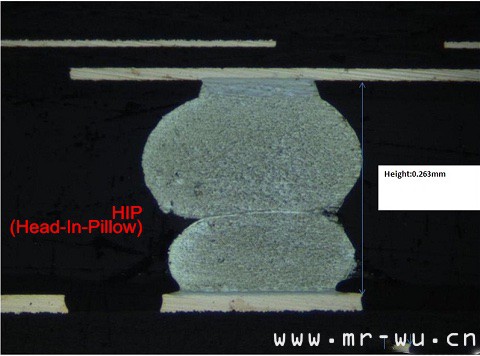
第二種BGA焊錫不良是界於HIP與正常焊錫之間的錫球,知道怎麼判斷那一面是PCB端了吧?從下圖看來BGA錫球與PCB上的錫膏已經完全熔融在一起了,因為看不到雙球,可是整個錫球卻有被上下拉長且幾乎斷裂的跡象,觀察 PCB面的焊錫也可以發現錫球與PCB焊墊接觸的面積變小了,而且還出現不蟳長的角度,這是因為錫球被整個往上拉開的緣故。這種焊錫斷裂應該只是早晚的問題,客戶端應該使用時的振動或是開關機過程的熱脹冷縮,都會加速其斷裂。
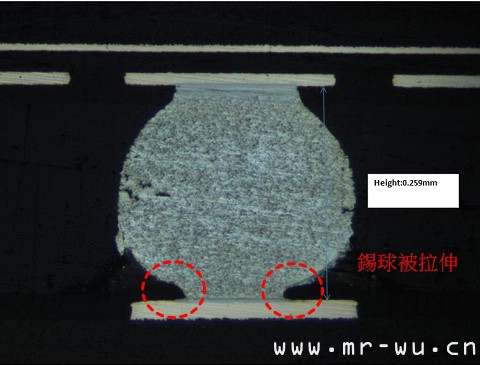
下面這張圖的BGA錫球焊接算還可以接受,球形也有壓扁形成水平橢圓形的焊錫,但還是看得出來靠近PCB端的錫球還是有點被拉開的情形。
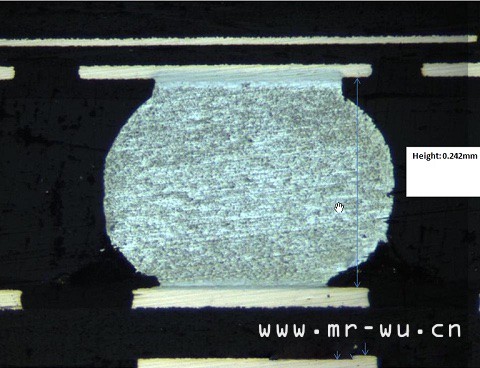
其實比較好的錫球焊接形狀應該要像下面這張圖片一樣,錫球類似一個「燈籠型」,錫球覆蓋在整個PCB焊墊上。不過有時候焊墊會設計成綠油覆蓋,形狀就會比較像上面那張圖了。
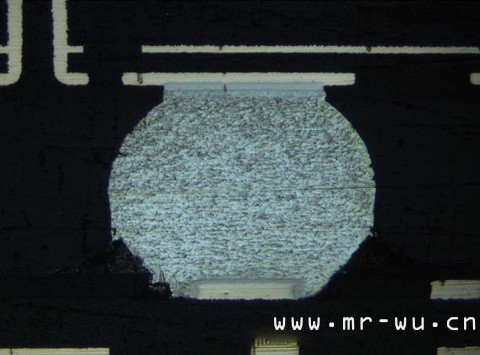



2 Comments
这BGA焊接质量检测不是通过X光仪来检测的嘛?
请问大神,这BGA切片是如何切出来的?